절연막
절연막의 종류
- 산화막(SiO2): 산소가 결합된 막으로 질화막보다 강한 절연 기능으로 절연막으로 사용한다.
- 질화막(Si3N4): 질소가 결합된 막으로 산화막 사이에 형성되어 보조 역할을 한다.
→ Si산화막을 사용하다가 CD(선폭의 임계크기)의 한계에 다다르자 45nm 이후부터는 높은 절연 재질이자 High - K 물질인 이산화하프늄(HfO2)과 ALD 방식에서는 이산화지르코늄(ZrO2)등이 새로운 물질로 적용되고 있다.
※ 산화막의 기반으로 Si를 사용하는 이유
1. Ge보다 양호한 부도체 역할을 한다.
2. Fab 공정 진행 중 필요하지 않은 다른 원소들의 확산을 차단한다.
3. 용융점이 1700 ºc 이상으로 산화 공정 이후에 어떤 공정 온도 조건도 만족한다.
산화막
열산화 방식(건식, 습식, 라디칼 산화), 증착 방식(CVD / ALD)으로 형성
- LOCOS (소자 분리): 과거에 채널 길이가 길었을 때 사용한 방법
1) 얇은 SiO2 산화막(pad oxide)을 열산화 방식으로 형성한다.

2) 그 위에 LPCVD방식으로 Si3N4막을 형성한다.

3) PR 도핑 후 노광, 식각으로 SiN 막을 패터닝해 준 후, PR을 제거해 준다.
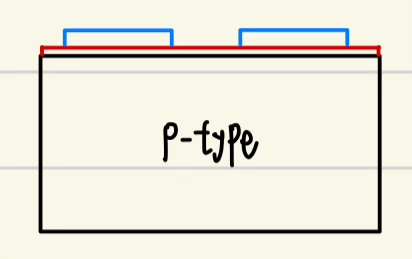
4) 열산화 방식으로 SiO2를 성장시켜 준다.

5) SiN막 제거

※ bird's break: LOCOS방식의 단점으로, SiO2 막이 소자 밑으로 침투하여 소자를 위로 휘게 만드는 현상이다.
- STI (소자 분리): bird's break 현상을 해결하고, SiO2막을 더 깊이 형성할 수 있다.
1) well을 형성하지 않을 부분을 PR로 도포한 후 이온 주입 공정으로 well 형성

2) 절연층(SiO2 ) = pad oxide을 산화 공정을 통해 증착한다.
후에 CMP 공정시 SiO2에 영향을 주지 않게 Silicon Nitride(Si3N4)를 CVD 공정으로 증착한다.
Si3N4는 SiO2보다 단단한 재질이기 때문에 잘 깎이지 않는다.

3) well 위에 PR을 도포한 후 RIE 공정으로 pwell과 nwell 사이에 우물을 만든다.

4) 깎인 면에 표면 결함이 있을 수 있으므로 산화 공정을 이용해 얇은 SiO2막 (liner)을 만든다.
HDPCVD 또는 APCVD로 우물을 채운다. (SiOx)

5) SiN 전까지 CMP 공정을 진행한다. (SiN은 잘 깎이지 않는다)

6) wet etching으로 SiN 제거한다 : STI 형성

- ILD (배선 분리): Si와 Metal을 절연해 주는 역할
- IMD (배선 분리): Metal 간 절연 역할
- passivation (배선 분리): 금속 배선을 보호하는 역할
- Gate Oxide (게이트 절연): 전류 차단, 전압 전달 = MOSFET에서 필수, 약 1.2nM
1) 게이트 층과 기판 층 간에 전류가 흐르는 것을 차단하고 전압을 기판층으로 전달하는 역할

Gate Oxide 두께가 얇아지면: 전자 차단이 어려워지지만 전압 전달이 용이해진다.
두꺼워지면: 전압 전달이 어려워져 채널이 제 때 생성되지 않는다.
2) 채널 형성의 역할을 한다. (TR의 동작 및 동작 속도와 직결)
→ 채널이 형성되어 Gate - Gate Oxide - channel 구조가 커패시터와 유사한 기능을 한다.
3) 비휘발성 메모리에서 정보 저장(두꺼운 막 지향)
: 낸드 TR은 FG에 전자를 장기간 가두어 정보를 저장한다. (Gate Oxide 막이 두꺼운 것이 유리)
4) 동작 속도 (얇은 막 지향)
: 전자를 Gate Oxide를 통과해 FG에 넣거나 FG에서 채널로 전자를 빼내야 하는데, 이때 Gate Oxide 막이 얇은 게 유리
따라서 낸드의 경우 디램보다 고려할 것이 많아 두께 선정이 어렵다.
※ Gate Oxide 재료의 변화

- 유전율이 높다: 전하를 잘 흡수하고 저장할 수 있다. (전기적 에너지를 효율적으로 저장)
- HKMG: High - K, Metal Gate(HfO2, ZrO2)
질화막
: 질화제로 질소가스 혹은 플라즈마를 사용한다. (CVD)

산화막끼리 서로 닿지 않게 칸막이 기능을 한다.
1차 산화막 + 질화막 + 2차 산화막의 구조는 O - N - O 절연막 구조이다.
'반도체 2모저모' 카테고리의 다른 글
| 산화 공정 - 에피택시(Epitaxy) (2) | 2024.04.01 |
|---|---|
| 산화 공정 (2) | 2024.03.29 |
| CMOS (2) | 2024.03.29 |
| 실리콘 웨이퍼 (0) | 2024.03.26 |
| 반도체란? (메모리 반도체와 시스템 반도체) (0) | 2024.03.25 |



